【行业】基础化工-半导体用光刻胶实现进口替代(18页)
光刻胶按显示的效果,可分为正性光刻胶和负性光刻胶。如果显影时未曝光部分溶解于显影液,形成的图形与掩膜版相反,称为负性光刻胶;如果显影时曝光部分溶解于显影液,形成的图形与掩膜版相同,称为正性光刻胶。由于负性光刻胶显影时易变形和膨胀,分辨率通常只能达到 2 微米,因此正性光刻胶的应用更为普及。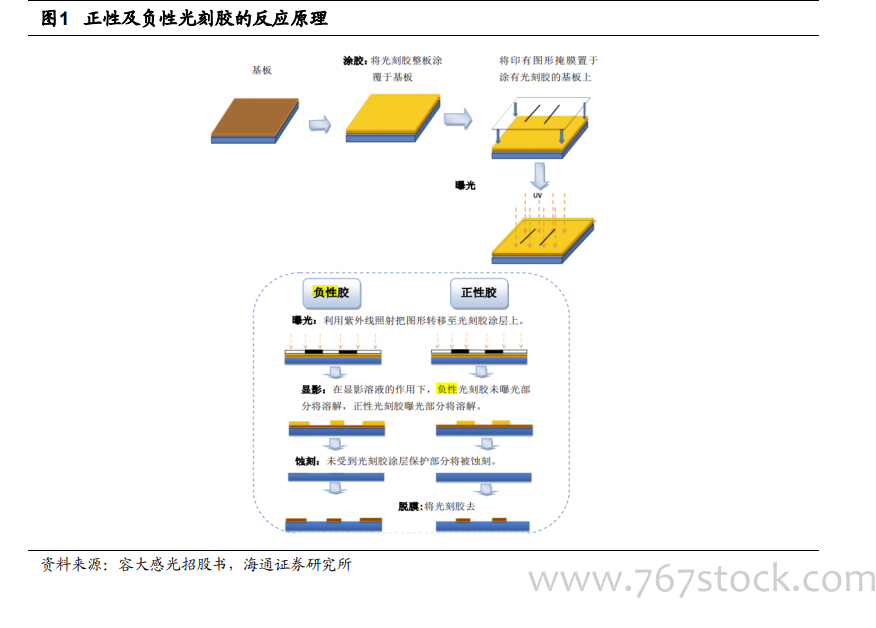 按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。随着科技的发展,现代电子电路越发向细小化集成化方向发展,随着对线宽的不同要求,光刻胶的配方有所不同,但应用相同,都是用于微细图形的加工,按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。
按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。随着科技的发展,现代电子电路越发向细小化集成化方向发展,随着对线宽的不同要求,光刻胶的配方有所不同,但应用相同,都是用于微细图形的加工,按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。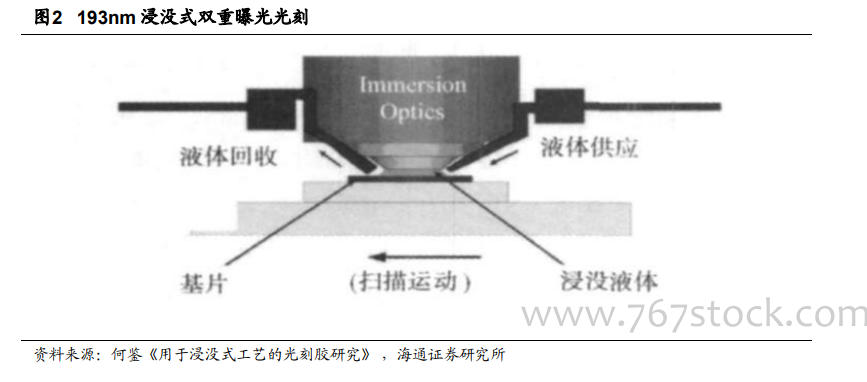 ArF 干法光刻胶和 ArF 湿法光刻胶均是晶圆制造光刻环节的关键工艺材料,ArF湿法光刻胶常用于更先进的技术节点。传统的干法光刻技术中,光刻机镜头与光刻胶之间的介质是空气,光刻胶直接吸收光源发出的紫外辐射并发生光化学反应,但在此种光刻技术中,光刻镜头容易吸收部分光辐射,一定程度上降低光刻分辨率,因此 ArF 干法光刻胶主要用于 55-90nm 技术节点;而湿法光刻技术中,光刻机镜头与光刻胶之间的介质是高折射率的液体(如水或其他化合物液体),光刻光源发出的辐射通过该液体介质后发生折射,波长变短,进而可以提高光刻分辨率,故 ArF 湿法光刻胶常用于更先进的技术节点,如 20-45nm。
ArF 干法光刻胶和 ArF 湿法光刻胶均是晶圆制造光刻环节的关键工艺材料,ArF湿法光刻胶常用于更先进的技术节点。传统的干法光刻技术中,光刻机镜头与光刻胶之间的介质是空气,光刻胶直接吸收光源发出的紫外辐射并发生光化学反应,但在此种光刻技术中,光刻镜头容易吸收部分光辐射,一定程度上降低光刻分辨率,因此 ArF 干法光刻胶主要用于 55-90nm 技术节点;而湿法光刻技术中,光刻机镜头与光刻胶之间的介质是高折射率的液体(如水或其他化合物液体),光刻光源发出的辐射通过该液体介质后发生折射,波长变短,进而可以提高光刻分辨率,故 ArF 湿法光刻胶常用于更先进的技术节点,如 20-45nm。
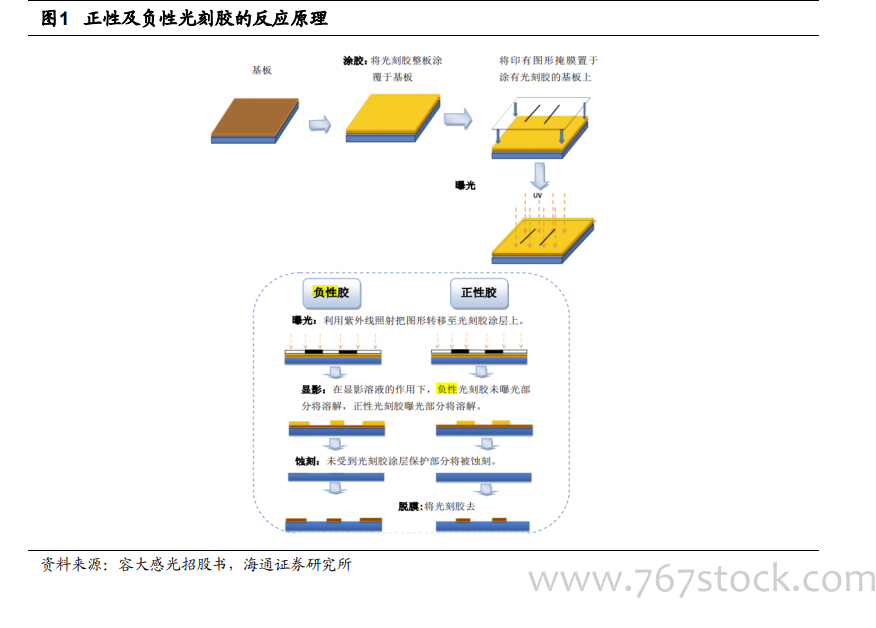 按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。随着科技的发展,现代电子电路越发向细小化集成化方向发展,随着对线宽的不同要求,光刻胶的配方有所不同,但应用相同,都是用于微细图形的加工,按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。
按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。随着科技的发展,现代电子电路越发向细小化集成化方向发展,随着对线宽的不同要求,光刻胶的配方有所不同,但应用相同,都是用于微细图形的加工,按照应用领域,光刻胶可以划分为半导体用光刻胶、平板显示用光刻胶、PCB 光刻胶。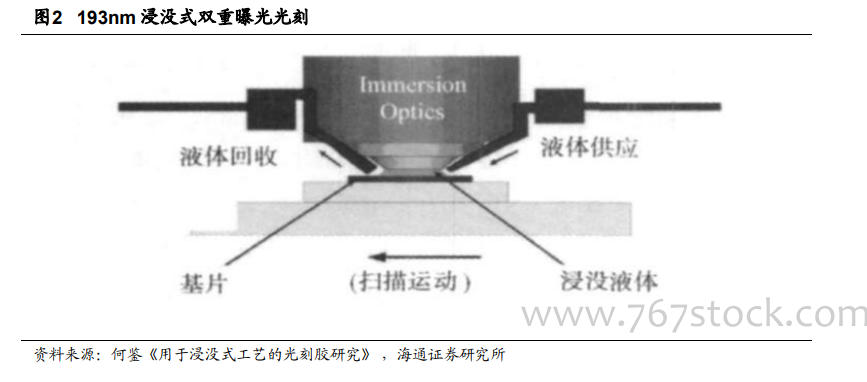 ArF 干法光刻胶和 ArF 湿法光刻胶均是晶圆制造光刻环节的关键工艺材料,ArF湿法光刻胶常用于更先进的技术节点。传统的干法光刻技术中,光刻机镜头与光刻胶之间的介质是空气,光刻胶直接吸收光源发出的紫外辐射并发生光化学反应,但在此种光刻技术中,光刻镜头容易吸收部分光辐射,一定程度上降低光刻分辨率,因此 ArF 干法光刻胶主要用于 55-90nm 技术节点;而湿法光刻技术中,光刻机镜头与光刻胶之间的介质是高折射率的液体(如水或其他化合物液体),光刻光源发出的辐射通过该液体介质后发生折射,波长变短,进而可以提高光刻分辨率,故 ArF 湿法光刻胶常用于更先进的技术节点,如 20-45nm。
ArF 干法光刻胶和 ArF 湿法光刻胶均是晶圆制造光刻环节的关键工艺材料,ArF湿法光刻胶常用于更先进的技术节点。传统的干法光刻技术中,光刻机镜头与光刻胶之间的介质是空气,光刻胶直接吸收光源发出的紫外辐射并发生光化学反应,但在此种光刻技术中,光刻镜头容易吸收部分光辐射,一定程度上降低光刻分辨率,因此 ArF 干法光刻胶主要用于 55-90nm 技术节点;而湿法光刻技术中,光刻机镜头与光刻胶之间的介质是高折射率的液体(如水或其他化合物液体),光刻光源发出的辐射通过该液体介质后发生折射,波长变短,进而可以提高光刻分辨率,故 ArF 湿法光刻胶常用于更先进的技术节点,如 20-45nm。




