【行业】半导体设备-原子层沉积技术是关键(20页)
一个完整的 ALD 周期可分为 4 个步骤:a)将气相反应前驱体 A 以脉冲形式通入反应腔,在衬底表面发生化学吸附;b)待表面吸附饱和后,通入惰性气体将剩余的反应前驱体和副产物带出反应腔;c)将气相反应前驱体 B 也以脉冲形式通入反应室,并与第一次化学吸附在衬底表面上的反应前驱体 A 反应;d)待反应完成后,再次通入惰性气体将多余的反应前驱体和副产物带出反应腔。通常一个周期需要 0.5 秒到几秒,生长的薄膜厚度大约为 0.01~0.3nm,不断重复循环这 4 个步骤即可完成整个 ALD 沉积过程。 典型的原子层沉积系统通常由前驱体源、气路系统、电子控制系统和真空系统构成。一种传统的、被广泛使用的 ALD 方法是热处理原子层沉积(Thermal ALD,TALD),即利用加热法来实现原子层沉积的技术。不过由于常规 TALD 技术存在沉积速率较低、对某些沉积薄膜的沉积温度要求较高等缺点,其在工业应用中受到限制。随着原子层沉积在实验中不断优化,研究人员将 ALD 技术与其他技术或物质结合,一系列新的 ALD 技术得以产生和发展,例如等离子体增强原子层沉积(Plasma Enhanced ALD, PEALD)、空间原子层沉积(Spatial ALD,SALD)、电化学原子层沉积(Electrochemical ALD, ECALD)等等。
典型的原子层沉积系统通常由前驱体源、气路系统、电子控制系统和真空系统构成。一种传统的、被广泛使用的 ALD 方法是热处理原子层沉积(Thermal ALD,TALD),即利用加热法来实现原子层沉积的技术。不过由于常规 TALD 技术存在沉积速率较低、对某些沉积薄膜的沉积温度要求较高等缺点,其在工业应用中受到限制。随着原子层沉积在实验中不断优化,研究人员将 ALD 技术与其他技术或物质结合,一系列新的 ALD 技术得以产生和发展,例如等离子体增强原子层沉积(Plasma Enhanced ALD, PEALD)、空间原子层沉积(Spatial ALD,SALD)、电化学原子层沉积(Electrochemical ALD, ECALD)等等。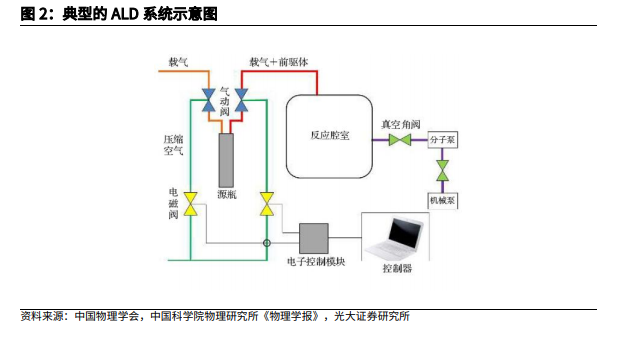 化学吸附自限制沉积(CS-ALD)过程中,第一种反应前驱体输入到基体材料表面并通过化学吸附保持在表面。当第二种前驱体通入反应器,就会与已吸附于基体材料表面的第一前驱体发生反应。两个前驱体之间发生置换反应,并产生相应的副产物,直到表面的第一前驱体完全消耗,反应会自动停止,并形成需要的原子层。而顺次反应自限制原子层沉积(RS-ALD)是通过活性前驱体物质与活性基体材料表面发生化学反应来驱动的,即得到的沉积薄膜是由前驱体与基体材料间的化学反应形成的。ALD 就是这两种自限制过程不断重复形成薄膜的技术。
化学吸附自限制沉积(CS-ALD)过程中,第一种反应前驱体输入到基体材料表面并通过化学吸附保持在表面。当第二种前驱体通入反应器,就会与已吸附于基体材料表面的第一前驱体发生反应。两个前驱体之间发生置换反应,并产生相应的副产物,直到表面的第一前驱体完全消耗,反应会自动停止,并形成需要的原子层。而顺次反应自限制原子层沉积(RS-ALD)是通过活性前驱体物质与活性基体材料表面发生化学反应来驱动的,即得到的沉积薄膜是由前驱体与基体材料间的化学反应形成的。ALD 就是这两种自限制过程不断重复形成薄膜的技术。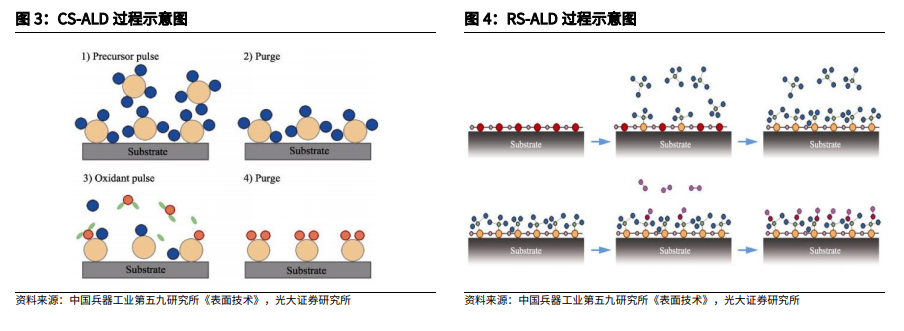
 典型的原子层沉积系统通常由前驱体源、气路系统、电子控制系统和真空系统构成。一种传统的、被广泛使用的 ALD 方法是热处理原子层沉积(Thermal ALD,TALD),即利用加热法来实现原子层沉积的技术。不过由于常规 TALD 技术存在沉积速率较低、对某些沉积薄膜的沉积温度要求较高等缺点,其在工业应用中受到限制。随着原子层沉积在实验中不断优化,研究人员将 ALD 技术与其他技术或物质结合,一系列新的 ALD 技术得以产生和发展,例如等离子体增强原子层沉积(Plasma Enhanced ALD, PEALD)、空间原子层沉积(Spatial ALD,SALD)、电化学原子层沉积(Electrochemical ALD, ECALD)等等。
典型的原子层沉积系统通常由前驱体源、气路系统、电子控制系统和真空系统构成。一种传统的、被广泛使用的 ALD 方法是热处理原子层沉积(Thermal ALD,TALD),即利用加热法来实现原子层沉积的技术。不过由于常规 TALD 技术存在沉积速率较低、对某些沉积薄膜的沉积温度要求较高等缺点,其在工业应用中受到限制。随着原子层沉积在实验中不断优化,研究人员将 ALD 技术与其他技术或物质结合,一系列新的 ALD 技术得以产生和发展,例如等离子体增强原子层沉积(Plasma Enhanced ALD, PEALD)、空间原子层沉积(Spatial ALD,SALD)、电化学原子层沉积(Electrochemical ALD, ECALD)等等。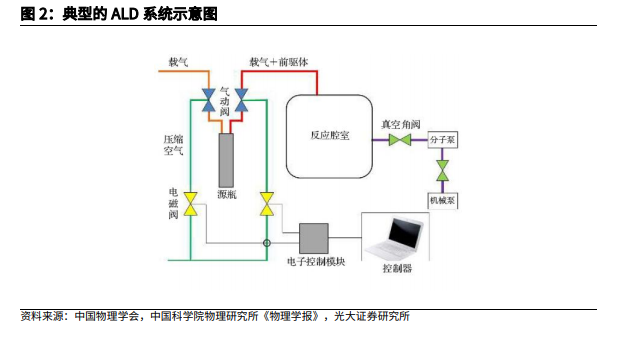 化学吸附自限制沉积(CS-ALD)过程中,第一种反应前驱体输入到基体材料表面并通过化学吸附保持在表面。当第二种前驱体通入反应器,就会与已吸附于基体材料表面的第一前驱体发生反应。两个前驱体之间发生置换反应,并产生相应的副产物,直到表面的第一前驱体完全消耗,反应会自动停止,并形成需要的原子层。而顺次反应自限制原子层沉积(RS-ALD)是通过活性前驱体物质与活性基体材料表面发生化学反应来驱动的,即得到的沉积薄膜是由前驱体与基体材料间的化学反应形成的。ALD 就是这两种自限制过程不断重复形成薄膜的技术。
化学吸附自限制沉积(CS-ALD)过程中,第一种反应前驱体输入到基体材料表面并通过化学吸附保持在表面。当第二种前驱体通入反应器,就会与已吸附于基体材料表面的第一前驱体发生反应。两个前驱体之间发生置换反应,并产生相应的副产物,直到表面的第一前驱体完全消耗,反应会自动停止,并形成需要的原子层。而顺次反应自限制原子层沉积(RS-ALD)是通过活性前驱体物质与活性基体材料表面发生化学反应来驱动的,即得到的沉积薄膜是由前驱体与基体材料间的化学反应形成的。ALD 就是这两种自限制过程不断重复形成薄膜的技术。