【行业】IC载板-国产替代加速推进快速成长(31页)
IC 载板是半导体封装的关键材料。集成电路产业链分为三个环节:芯片设计、晶圆制造和封装测试。封装不仅起到保护芯片和增强导热性的作用,也可以连通外部的电路与芯片内部以达到固定芯片的作用。IC 封装基板(IC PackageSubstrate,简称 IC 载板,也称为封装基板)是封装测试环节中的关键载体,用于建立 IC 与 PCB 之间的讯号连接,IC 载板还能够发挥保护电路,固定线路并导散余热的作用。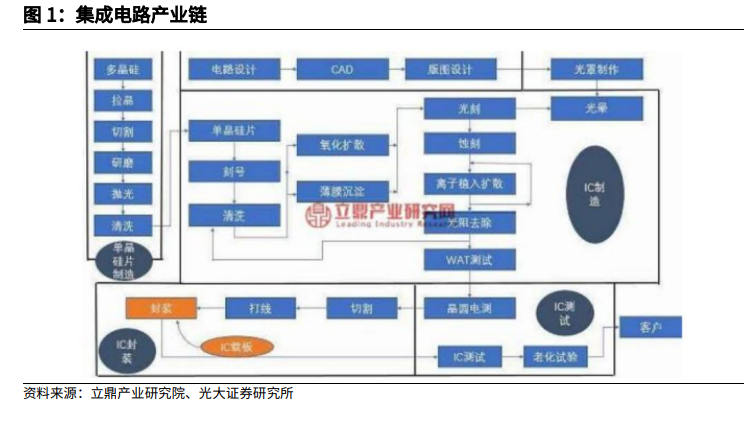 IC 载板被应用于主流的封装技术中。半导体芯片封装经历了几代的变迁,以封装技术分类为 DIP 封装(双列直插式封装技术)、SOP 封装(小外形封装)、QFP 封装(小型方块平面封装)、PGA 封装(插针网格阵列封装技术)、BGA封装(焊球阵列封装)、SIP 封装(系统级封装)。技术的迭代与升级让当前的封装面积与芯片面积可以接近于 1。以 BGA(Ball grid array)封装为例,它是一种高密度封装技术,区别于其他封装芯片引脚分布在芯片周围,BGA 引脚在封装的底面,使 I/O 端子间距变大,可容纳的 I/O 数目变多。BGA 封装凭借着成品率高、电特性好、适用于高频电路等特点成为了目前主流的封装技术之一。BGA 的基础上逐渐衍生出 CSP,MCM 和 SIP 等高密度 IC 封装方式。先进封装技术更加迎合集成电路微小化、复杂化、集成化的特点,IC 载板因其高精度、高密度、小型化和薄型化的特点被广泛应用于主流封装技术中。
IC 载板被应用于主流的封装技术中。半导体芯片封装经历了几代的变迁,以封装技术分类为 DIP 封装(双列直插式封装技术)、SOP 封装(小外形封装)、QFP 封装(小型方块平面封装)、PGA 封装(插针网格阵列封装技术)、BGA封装(焊球阵列封装)、SIP 封装(系统级封装)。技术的迭代与升级让当前的封装面积与芯片面积可以接近于 1。以 BGA(Ball grid array)封装为例,它是一种高密度封装技术,区别于其他封装芯片引脚分布在芯片周围,BGA 引脚在封装的底面,使 I/O 端子间距变大,可容纳的 I/O 数目变多。BGA 封装凭借着成品率高、电特性好、适用于高频电路等特点成为了目前主流的封装技术之一。BGA 的基础上逐渐衍生出 CSP,MCM 和 SIP 等高密度 IC 封装方式。先进封装技术更加迎合集成电路微小化、复杂化、集成化的特点,IC 载板因其高精度、高密度、小型化和薄型化的特点被广泛应用于主流封装技术中。 IC 载板制作工艺有两种,分别为 SAP(半加成法)和 MSAP(改良半加成法),用于生产线宽/线距小于 25μm,工艺流程更加复杂的产品。SAP 和 MSAP 制作原理相似,简述为在基板上涂覆薄铜层,随后进行图形设计,再电镀上所需厚度的铜层,最终移除种子铜层。两种工艺流程的基本差异是种子铜层的厚度。SAP工艺从一层薄化学镀铜涂层(小于 1.5um)开始,而 MSAP 从一层薄的层压铜箔(大于 1.5mum)开始。
IC 载板制作工艺有两种,分别为 SAP(半加成法)和 MSAP(改良半加成法),用于生产线宽/线距小于 25μm,工艺流程更加复杂的产品。SAP 和 MSAP 制作原理相似,简述为在基板上涂覆薄铜层,随后进行图形设计,再电镀上所需厚度的铜层,最终移除种子铜层。两种工艺流程的基本差异是种子铜层的厚度。SAP工艺从一层薄化学镀铜涂层(小于 1.5um)开始,而 MSAP 从一层薄的层压铜箔(大于 1.5mum)开始。
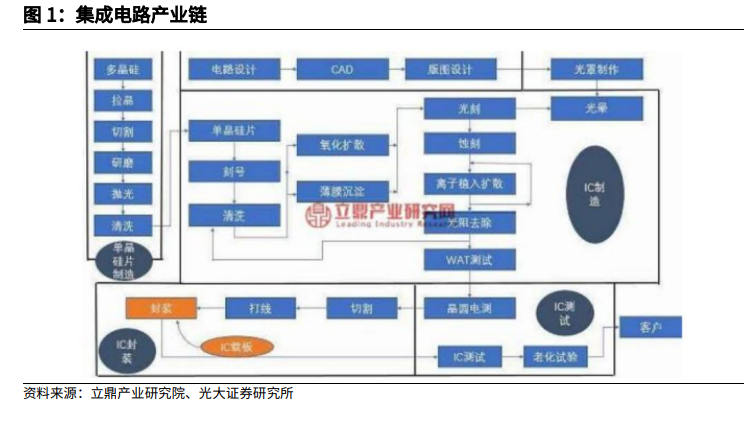 IC 载板被应用于主流的封装技术中。半导体芯片封装经历了几代的变迁,以封装技术分类为 DIP 封装(双列直插式封装技术)、SOP 封装(小外形封装)、QFP 封装(小型方块平面封装)、PGA 封装(插针网格阵列封装技术)、BGA封装(焊球阵列封装)、SIP 封装(系统级封装)。技术的迭代与升级让当前的封装面积与芯片面积可以接近于 1。以 BGA(Ball grid array)封装为例,它是一种高密度封装技术,区别于其他封装芯片引脚分布在芯片周围,BGA 引脚在封装的底面,使 I/O 端子间距变大,可容纳的 I/O 数目变多。BGA 封装凭借着成品率高、电特性好、适用于高频电路等特点成为了目前主流的封装技术之一。BGA 的基础上逐渐衍生出 CSP,MCM 和 SIP 等高密度 IC 封装方式。先进封装技术更加迎合集成电路微小化、复杂化、集成化的特点,IC 载板因其高精度、高密度、小型化和薄型化的特点被广泛应用于主流封装技术中。
IC 载板被应用于主流的封装技术中。半导体芯片封装经历了几代的变迁,以封装技术分类为 DIP 封装(双列直插式封装技术)、SOP 封装(小外形封装)、QFP 封装(小型方块平面封装)、PGA 封装(插针网格阵列封装技术)、BGA封装(焊球阵列封装)、SIP 封装(系统级封装)。技术的迭代与升级让当前的封装面积与芯片面积可以接近于 1。以 BGA(Ball grid array)封装为例,它是一种高密度封装技术,区别于其他封装芯片引脚分布在芯片周围,BGA 引脚在封装的底面,使 I/O 端子间距变大,可容纳的 I/O 数目变多。BGA 封装凭借着成品率高、电特性好、适用于高频电路等特点成为了目前主流的封装技术之一。BGA 的基础上逐渐衍生出 CSP,MCM 和 SIP 等高密度 IC 封装方式。先进封装技术更加迎合集成电路微小化、复杂化、集成化的特点,IC 载板因其高精度、高密度、小型化和薄型化的特点被广泛应用于主流封装技术中。 IC 载板制作工艺有两种,分别为 SAP(半加成法)和 MSAP(改良半加成法),用于生产线宽/线距小于 25μm,工艺流程更加复杂的产品。SAP 和 MSAP 制作原理相似,简述为在基板上涂覆薄铜层,随后进行图形设计,再电镀上所需厚度的铜层,最终移除种子铜层。两种工艺流程的基本差异是种子铜层的厚度。SAP工艺从一层薄化学镀铜涂层(小于 1.5um)开始,而 MSAP 从一层薄的层压铜箔(大于 1.5mum)开始。
IC 载板制作工艺有两种,分别为 SAP(半加成法)和 MSAP(改良半加成法),用于生产线宽/线距小于 25μm,工艺流程更加复杂的产品。SAP 和 MSAP 制作原理相似,简述为在基板上涂覆薄铜层,随后进行图形设计,再电镀上所需厚度的铜层,最终移除种子铜层。两种工艺流程的基本差异是种子铜层的厚度。SAP工艺从一层薄化学镀铜涂层(小于 1.5um)开始,而 MSAP 从一层薄的层压铜箔(大于 1.5mum)开始。




